Lexikon der Optik: Photolithographie
Photolithographie, ein Verfahren der Mikrolithographie zur Bearbeitung von Oberflächen, wobei die in einer Maske gespeicherten Informationen durch photographische Abbildung in eine strahlungsempfindliche Schicht (Photoresist) übertragen und zur Strukturierung dieser Schicht genutzt werden.
1) Das Grundprinzip der Photolithographie. Durch die Beleuchtungseinrichtung (Lichtquelle und Kondensor) wird eine gleichmäßige Ausleuchtung der Maske erreicht (Abb. 1). Die in der Maske in Form von Transparenz- und/oder Phasenunterschieden gespeicherte Information wird durch die Abbildungseinrichtung in die auf das zu strukturierende Substrat aufgebrachte Photoresistschicht übertragen. In dieser entstehen dabei Löslichkeitsunterschiede. Bei der Entwicklung der Photoresistschicht werden die Gebiete mit größerer Löslichkeit herausgelöst, so daß auf dem Substrat ein der Maske entsprechendes Resistrelief entsteht (Abb. 2). Wird durch die Lichteinwirkung die Löslichkeit erhöht, spricht man von Positivverfahren, andernfalls, wenn die Löslichkeit verringert wird, von Negativverfahren. Das Substrat kann durch Verschieben des Tisches (in x- und y-Richtung sowie Winkelkorrektur) zur Maske justiert werden, so daß die Abbildung paßgenau zu bereits auf dem Substrat befindlichen Strukturen erfolgen kann. Um die Resistschicht optimal in die Bildebene zu bringen, ist zusätzlich eine Verschiebung des Tisches in z-Richtung erforderlich (Fokussierung).
2) Entwicklung der Photolithographie. Die P. ist eines der ältesten photographischen Verfahren. J.N. Niépce stellte 1823 eine Methode zur Reproduktion transparenter Zeichnungen vor. Dabei wurde die Zeichnung auf eine mit arabischem Asphalt beschichtete Schieferplatte gelegt und im Sonnenlicht kopiert. Der UV-Anteil bewirkt eine von der Bestrahlungsdosis abhängige Änderung der Löslichkeit des Asphalts (Photopolymerisation) in Lösungsmitteln (Äther). Durch Herauslösen der unbestrahlten, in der Zeichnung geschwärzten Gebiete wird ein der Zeichnung entsprechendes Relief erzeugt (Negativverfahren). Nach Einfärben dieses Reliefs mit einer Farbpaste kann die Platte zum Drucken genutzt werden. Von diesem Verfahren kommt auch die Bezeichnung Photolithographie, "Zeichnen mit Licht auf Stein".
Die Asphaltschicht wurde inzwischen durch voll synthetisierte Photoresistschichten ersetzt. Die P. fand erste Anwendungen in der Drucktechnik und bei der Herstellung von Leiterplatten. Mit der Erfindung des Transistors und der Planartechnologie zur Herstellung mikroelektronischer Bauelemente und Schaltkreise wurde sie zu einem der wichtigsten Produktionsverfahren des ausgehenden 20. und beginnenden 21. Jahrhunderts. Ein Beispiel zeigt Abb. 3. Die große Bedeutung der P. ist einerseits in ihrer hohen Produktivität gegenüber schreibenden Verfahren (Elektronen- und Ionenstrahllithographie), den relativ geringen Kosten und der einfachen Handhabung (z.B. im Vergleich zur Röntgenlithographie) begründet. Andererseits erkannte die optische Industrie sehr schnell die Bedeutung und Chancen des durch die Mikroelektronik und Informationstechnik erschlossenen, sich rasch entwickelnden neuen Marktes. Vom Trend zur Miniaturisierung getrieben, konnte sie rechtzeitig immer leistungsfähigere photolithographische Geräte zur Verfügung stellen. Die entwickelten Verfahren finden immer neue Anwendungsgebiete wie beispielsweise Mikromechanik und integrierte Optik.
3) Belichtungsgeräte und Verfahren für die Photolithographie. Deren Einteilung kann nach unterschiedlichen Kriterien erfolgen. Hinsichtlich der zur Abbildung genutzten Strahlung ist zunächst zwischen polychromatischer und monochromatischer Abbildung zu unterscheiden. Um den Aufwand zur chromatischen Korrektur der Linsen zu verringern, werden in den neueren Hochleistungsgeräten nur monochromatische Verfahren genutzt. Als Lichtquellen kommen insbesondere Quecksilber-Hochdruck-Entladungslampen in Frage. Die zur Abbildung ausgefilterte Quecksilberlinie wird zur Bezeichnung der Lithographie verwendet (g-Linie bei der Wellenlänge 436 nm, i-Linie bei 365 nm). Verkleinerung der Wellenlänge bedeutet Verringerung der realisierbaren Strukturbreiten und Erhöhung der Speicherdichte, d.h., auf der gleichen Siliciumfläche können mehr Bauelemente untergebracht werden (Tab.). Obwohl der Aufwand steigt, sinken durch die bessere Flächenausnutzung die Herstellungskosten pro Bauelement.

Es ist zu beachten, daß natürliche Linienbreite und Untergrundstrahlung trotzdem noch eine chromatische Korrektur erfordern. Um auf diese verzichten zu können, müssen Linienbreiten im Pikometerbereich realisiert werden. Das ist auch bei Verwendung von Laserstrahlung nur durch erhöhten Aufwand erreichbar. Das gilt vor allem für den Einsatz von Excimerlasern zur weiteren Verringerung der Belichtungswellenlänge (DUV-Lithographie, DUV Abk. für Deep Ultraviolet bei 248 nm und 193 nm). Weitere Verkürzung der Wellenlänge (Extreme Ultraviolet, EUV) führt schließlich zu weicher Röntgenstrahlung. Deren Nutzung für Lithographieverfahren befindet sich noch in der Entwicklungsphase. Strahlungsquellen hierfür sind laser- oder mikrowelleninduzierte Plasmaquellen.
Der Kondensor hat die Aufgabe, eine gleichmäßige Ausleuchtung der Maske und eine konstante Beleuchtungsapertur für alle Maskenpunkte zu gewährleisten. Durch die spezielle Kondensorkonstruktion (Wabenkondensor) wird ein Durchmischen des von verschiedenen Punkten der Lichtquelle ausgehenden Lichtes und damit eine bessere Homogenität erreicht.
Die Maske besteht aus einer hochebenen Glas- oder Quarzplatte. In die Absorberschicht (in der Regel eine dünne, das Licht vollständig absorbierende Chromschicht) sind die der gewünschten Struktur entsprechenden Fenster geätzt. Die Qualität der Maske und damit ihr Preis werden außer durch das Strukturniveau (kleinste vorkommende Sturkturbreiten, Komplexität und Maßgenauigkeit) durch die Forderungen an die Defektfreiheit maßgeblich bestimmt. Eine gute Maske darf keine Löcher in der Absorberschicht und keine Chromreste oder Partikel in den geöffneten Fenstern enthalten bzw. muß die Dimension derartiger Defekte unter der Auflösungsgrenze des Abbildungssystems liegen. Die Herstellung der Masken erfolgt auf lithographischem Wege mittels Laser- oder Elektronenstrahlschreiber.
Eine Verbesserung der Abbildungsleistung kann durch die Verwendung von Phasenmasken erreicht werden. Durch die Erzeugung phasenschiebender Strukturen (z.B. Unterätzung der Chromkanten in das Maskensubstrat) kann die Kontrastübertragung für Strukturen nahe der Auflösungsgrenze verbessert werden. Es ist auch möglich, die gesamte Bildinformation in Phasenunterschieden zu speichern (z.B. durch Ätzen der Strukturen in das Maskensubstrat, wobei die Ätztiefe einem Gangunterschied von der halben Wellenlänge entspricht). Derartige Masken bedürfen keiner absorbierender Schichten und werden deshalb auch als Transmissionsmasken bezeichnet. Sie ermöglichen eine weitere Verringerung der minimal realisierbaren Strukturbreite, erfordern aber komplizierte Verfahren zu ihrer Herstellung. Da nur Phasensprünge abgebildet werden, geht der unmittelbare Zusammenhang zwischen Maskenbild und gewünschtem Resistmuster verloren.
Die Bildübertragung von der Maske in die Resistschicht kann ohne optische Hilfsmittel durch Schattenprojektion erfolgen. Bei Abständen von einigen Mikrometern zwischen Maske und Resistoberfläche können noch minimale Strukturbreiten von 2 μm übertragen werden. Eine Verringerung des Abstandes auf Null (Hartkontakt) ermöglicht die Strukturierung im Submikrometerbereich. Partikel auf der Resist- oder Maskenoberfläche führen jedoch zu Abbildungsfehlern. (Der Abstand ist dann gleich der Partikelgröße). Außerdem werden durch die Berührung von Masken- und Resistoberfläche Defekte in beiden Materialien hervorgerufen, die letztlich zur Zerstörung der Maske führen. Moderne Verfahren der Mikrolithographie nutzen deshalb fast ausschließlich die Projektionslithographie. Hierbei wird die Maske durch ein optisches Verfahren in die Resistschicht abgebildet. Der Abbildungsmaßstab wird dabei bestimmt durch die Forderung nach einfacher und sicherer Maskenherstellung sowie durch die noch zu akzeptierende Maskengröße, die optischen Übertragungseigenschaften und die geforderte Bildfeldgröße. Eine verkleinernde Abbildung der Maske im Maßstab 5:1 hat sich als Standard durchgesetzt.
Die zur Abbildung eingesetzten Objektive sind meist telezentrisch aufgebaute komplexe Linsensysteme, die einen sehr hohen Korrektionszustand aufweisen müssen. Bildfehler vergrößern einerseits Strukturbreiteschwankungen, andererseits können sie zu Verzerrungen im Bildfeld führen. Bei numerischen Aperturen bis zu 0,65 können Bildfelder mit Durchmessern bis zu 30 mm realisiert werden. Bedingt durch die weitere Verringerung der Wellenlänge werden insbesondere katadioptrische Systeme zunehmend interessant.
Die Bildfeldgröße (z.B. 25×25 mm2) ist im allgemeinen bedeutend kleiner als die zu strukturierende Substratfläche (z.B. Wafer mit einem Durchmesser von 200 mm). Um die gesamte Waferfläche zu strukturieren, wird beim Waferstepper nacheinander Bildfeld an Bildfeld gesetzt. Beim Waferscanner wird nur der durch einen Spalt beleuchtete Teil der Maske abgebildet. Um den gesamten Maskeninhalt zu übertragen, müssen Maske und Substrat im Verhältnis des Abbildungsmaßstabes gegeneinander bewegt werden. Vorteile liegen in der einfacheren Linsenkorrektur (kleineres Bildfeld) und der verbesserten Korrektur der Fokussierung.
Die nach der Entwicklung auf dem Substrat erzeugte Photoresistmaske wird zur Strukturierung des Substrates genutzt. Typische Beispiele sind die Verwendung der Resistmaske als Ätzmaske zur naßchemischen oder plasmachemischen Bearbeitung der darunter liegenden technologischen Schichten. Voraussetzung dafür ist, daß der strukturierte Photoresist der Ätzbelastung standhält. Sollen beispielsweise Fenster für Kontakte in eine Siliciumdioxidschicht geätzt werden, muß der Resist dem Angriff des Ätzmittels (Flußsäure beim naßchemischen Ätzen oder F--Ionen beim plasmachemischen Ätzen) in der zur Ätzung erforderlichen Zeit widerstehen.
Bei der Ionenimplantation wird die Resistmaske als Implantationsmaske genutzt. Die Resistdicke muß dabei so gewählt werden, daß die auftreffenden Ionen im Resist steckenbleiben und nur in den Gebieten das Substrat erreichen und dotieren, wo der Resist entsprechend der Belichtung im Entwickler weggelöst wurde.
Durch die Bearbeitung des Substrates wird die Resistmaske stark belastet und in ihrem chemisch-physikalischen Verhalten verändert. Daraus können Probleme bei der im allgemeinen erforderlichen Entfernung der Resistschicht nach der Substratbearbeitung (Resiststrippen) resultieren. Im fertigen Produkt (z.B. Schaltkreis) ist die P. nur im Muster und den Strukturen des bearbeiteten Substrates erkennbar.
4) Physikalische Grundlagen und Effekte. Das Auflösungsvermögen in der P. ist beugungsbegrenzt. Entsprechend dem Rayleigh-Kriterium ist die kleinste auflösbare Struktur b bei der Belichtungswellenlänge λ und der numerischen Apertur NA gegeben durch b=k1λ/NA. Der Faktor k1 ist dabei abhängig vom Strukturtyp (für Punktauflösung ist k1=0,61) und der angewandten Technologie (Verhalten des Photoresists).
Die Schärfentiefe ΔFoc berechnet sich zu ΔFoc=k2λ/NA2. Hier bezeichnet k2 wiederum einen technologieabhängigen Faktor, der für Abschätzungen meist =1 gesetzt wird. Eine Verkleinerung der Strukturbreite kann durch Verringerung der Wellenlänge und Vergrößerung der numerischen Apertur erfolgen. In beiden Fällen wird die Schärfentiefe verringert, wobei die numerische Apertur jedoch quadratisch eingeht.
Zur detaillierteren Betrachtung wurden Simulationsprogramme entwickelt. Sie dienen einem besseren Prozeßverständnis und werden zunehmend zur Prozeßoptimierung genutzt. Moderne Verfahren (Verwendung von Phasenmasken, optische Proximitykorrektur, d.h. die Berücksichtigung der optischen Wechselwirkung benachbarter Strukturen) sind ohne Nutzung der Simulation nicht beherrschbar. Hinsichtlich der optischen Abbildung beruhen sie auf der Theorie der partiell kohärenten Abbildung. Interferenzeffekte in dünnen Substratschichten und der Resistschicht müssen dabei berücksichtigt werden. Ausdruck der Interferenz ist z.B. die Ausbildung stehender Wellen in der Resistschicht. Zu beachten ist weiterhin, daß sich die optischen Eigenschaften der Resistschicht während der Belichtung ändern. Der optische Einfluß des Substrates kann durch Antireflexionsschichten reduziert oder eliminiert werden. Das ist besonders wichtig, wenn die Substrattopologie als Hohlspiegel wirken kann.

Photolithographie 1: Prinzip.

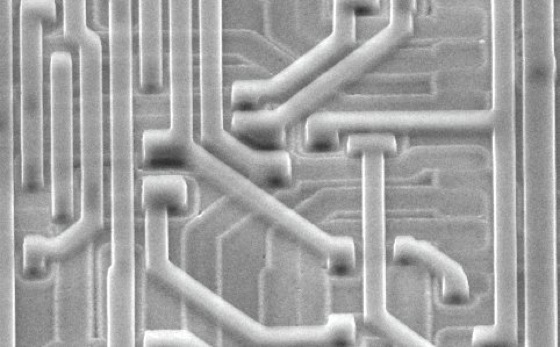
Schreiben Sie uns!