Lexikon der Optik: Infrarotellipsometrie
Infrarotellipsometrie, Ellipsometrie im IR-Gebiet bei Wellenzahlen σ ![]()
104/m. Aufgrund der Intensitätsprobleme in diesem Gebiet werden für das Arbeiten bei festen Wellenzahlen Laser als Lichtquellen oder für die spektroskopische I. eine Kopplung des Infrarot-Fourier-Spektrometers mit dem photometrischen Ellipsometer verwendet. Abb. 1 zeigt das Prinzip der letztgenannten Anordnung mit einem Retarder im Strahlengang (für die Messung aller vier Stokes-Parameter erforderlich). Von der Quelle gelangt die Strahlung über das Fourier-Spektrometer und das photometrische Ellipsometer zum Detektor. Dabei nutzt man den hohen Lichtleitwert und den Multiplexvorteil des Interferometers (Fourier-Spektroskopie). Es werden Spektren in unterschiedlichen Winkelstellungen des Polarisators gemessen (mindestens vier Positionen, z.B. α1=0°, 45°, 90°, 135°). Während der Messung darf der Polarisator nicht verändert werden. Die polarisierende Wirkung des Fourier-Spektrometers selbst wird durch Eichmessungen berücksichtigt. Aus den Spektren werden durch Fourier-Analyse bezüglich α1 die Stokes-Parameter berechnet (Ellipsometer) und anschließend die optischen Konstanten ermittelt. Eine andere Variante der I. besteht darin, daß man einen zeitabhängigen Retarder in Gestalt eines photoelastischen Modulators verwendet. Der zugrunde liegende physikalische Mechanismus ist dabei der folgende: Eine angelegte elektrische Spannung führt vermöge Elektrostriktion zum Auftreten einer mechanischen Spannung, die wiederum optische Doppelbrechung hervorruft (Spannungsdoppelbrechung). Ist die elektrische Spannung eine Wechselspannung der (Kreis-)Frequenz Ω, so erhält man einen Retarder, der einen periodisch sich ändernden Gangunterschied δ=δmaxsinΩt (t Zeit) erzeugt. Als Material wird die Substanz ZnSe verwendet, die im Wellenzahlbereich von 70000 bis 400000 m-1 durchlässig ist. Die gemessene Intensität zeigt die gleiche Periodizität wie δ und kann daher in eine Fourier-Reihe entwickelt werden. Aus den mit Ω und 2Ω oszillierenden Anteilen können die elliptischen Parameter Δ und Ψ der Strahlung bestimmt werden.
Die I. liefert die optischen Materialdaten für sonst der Messung schwer zugängliche Proben, besonders im Falle großer spektraler Absorptionszahlen (Κ ![]()
0,1), z.B. für Metalle, Gläser, Gesteine, Tone u.a. Die ATR-Ellipsometrie im IR-Bereich gestattet die Messung der absoluten Werte von n (reeller Brechungsindex) und Κ in Abhängigkeit von der Wellenzahl. Die konventionelle ATR-Methode kann dagegen nur die Wellenzahlposition der Absorption ermitteln. Durch die I. wird stets der sonst im IR-Bereich schwer zugängliche Brechungsindex n neben der Absorptionszahl Κ gemessen, auch innerhalb von Absorptionsbanden, wo anomale Dispersion vorliegt. Depolarisierende Streuung, die durch Rauhigkeiten der reflektierenden Oberfläche oder anderweitig bedingt ist, kann über die Messung aller vier Stokes-Parameter mit Hilfe des Retarders erfaßt und bei der Auswertung rechnerisch berücksichtigt werden. Die Abb. 2 zeigt mit der I. ermittelte Werte der optischen Konstanten für eine polierte Quarzglasprobe in Abhängigkeit von der Wellenzahl und die daraus berechnete Reflexion für senkrechten Einfall des Lichtes.
Substrat-Schicht-Kombinationen können mit der I. ebenfalls erfolgreich untersucht werden (Ellipsometrie). Dünne Filme lassen sich bis in den Bereich von Monolagen von Molekülen oder Atomen charakterisieren.
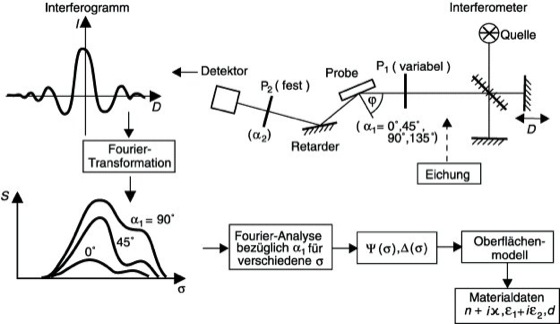
Infrarotellipsometrie 1: Infrarot-Ellipsometer. P1, P2 Polarisatoren; α1, α2 deren Einstellwinkel, σ Wellenzahl, I Intensität, ψ und Δ ellipsometrische Parameter, n+iΚ komplexer Brechungsindex, ε1+iε2 komplexe Dielektrizitätskonstante, d Schichtdicke.

Infrarotellipsometrie 2: Ellipsometrisch bestimmte Werte des Brechungsindexes n, des Reflexionsvermögens R und der spektralen Absorptionszahl Κ für SiO2 (Einfallswinkel ϕ=70°, spektrale Auflösung δσ=800/m).
Wenn Sie inhaltliche Anmerkungen zu diesem Artikel haben, können Sie die Redaktion per E-Mail informieren. Wir lesen Ihre Zuschrift, bitten jedoch um Verständnis, dass wir nicht jede beantworten können.